XPS (ESCA) bei nanoAnalytics: präzise Oberflächenanalyse für messbare Ergebnisse.
Mit der Röntgen Photoelektronenspektroskopie bestimmen wir quantitativ Elementzusammensetzungen, Bindungs /Oxidationszustände und Schichtdicken in den obersten 1–10 nm – schnell, reproduzierbar und industrieerprobt. So klären wir Haftungsprobleme, Kontaminationen, Korrosionsmechanismen und komplexe Dünnschichtfragen sicher auf und liefern umsetzbare Handlungsempfehlungen für Qualitätssicherung, Prozessoptimierung und Entwicklung.
Die nanoAnalytics GmbH ist ein durch die DakkS geprüftes und für die Photoelektronenspektroskopie (XPS) nach ISO 17025 akkreditiertes Prüflabor. Als akkreditiertes Prüflabor mit tiefer wissenschaftlicher Expertise verbinden wir modernste Instrumentierung (inkl. ARXPS und Sputter Tiefenprofilen mit Argon Cluster Ionen) mit klaren, entscheidungsrelevanten Reports – damit Sie schneller zur belastbaren Ursache und zur richtigen Lösung kommen.
- XPS/ESCA ist eine hochsensitive, quantitative Methode zur chemischen Oberflächenanalyse (Informationstiefe ca. 1–10 nm).
- Lieferbar sind Elementzusammensetzung (alle Elemente außer H/He), Bindungs-/Oxidationszustände, Mapping sowie Tiefeninformationen (ARXPS, Sputter-Tiefenprofil).
- Typische Einsatzfelder: Dünnschichten, Haftung/Adhäsion, Kontamination/Sauberkeit, Korrosion, Elektronik/Bondpads, Polymere.

Was ist eine XPS Analyse? Die Methode kurz und verständlich erklärt
Bei der XPS wird eine Probe im Ultrahochvakuum (UHV) mit monochromatischer Röntgenstrahlung (meist Al Kα) bestrahlt. Durch den äußeren Photoeffekt emittierte Elektronen werden energieanalysiert und ihrer elementspezifischen Bindungsenergie zugeordnet. Aufgrund der geringen inelastischen mittleren freien Weglänge von Elektronen ist XPS äußerst oberflächensensitiv (typisch < 10 nm).
Leistungsmerkmale der XPS: Präzise Analytik & Nachweisgrenzen
- Quantitative Elementanalyse inkl. Nachweis aller Elemente außer H und He; Nachweisgrenzen bis ~0,1 at%.
- Bestimmung von Bindungs-/Oxidationszuständen ("chemical shift").
- Tiefenprofilierung (Sputtern) über Schichtdicken bis in den µm-Bereich.
- Ortsaufgelöste Analyse (Small-Spot, Mapping) bis Ø ~10 – 400 µm.
- Winkelaufgelöste XPS (ARXPS) für ultradünne Schichten (< 10 nm).

Kurzprofil XPS-Laboranalysen
- Quantitative Analyse der Oberflächenzusammensetzung
- Nachweis aller Elemente außer H und He
- Analyse von Bindungs-/Oxidationszuständen, Identifizierung funktioneller Gruppen
- Nicht-destruktiv, hohe Empfindlichkeit
- Schichtdicke/ Oxidationstiefe (ARXPS, Overlayer‑Modelle zur Schichtdickenberechnung)
- Sputter-Tiefenprofile für Schichtsysteme
- Reinheit/Kontamination, Fehleranalytik (Verfärbungen, Korrosion, Haftung)
- Lokale Informationen via variabler Spotgröße
XPS-Anwendungen in Materialprüfung und Fehleranalytik
Die XPS-Analyse ist ein vielseitiges Werkzeug zur Lösung komplexer Fragestellungen in zahlreichen Branchen.
| Anwendungsfeld | Beschreibung |
|---|---|
| Dünnschicht- & Schichtsystem-Analytik | Schichtdicke & Zusammensetzung funktionaler Beschichtungen auf Glas, Metallen, Polymeren. |
| Fehler- & Schadensanalytik | Haftungsprobleme/Delamination, Korrosion, Kontaktprobleme – Grenzflächenchemie verstehen. |
| Qualitätssicherung | Sauberkeitsanalyse, Identifizierung organischer/anorganischer Rückstände (z. B. in Mikroelektronik/Medizintechnik). |
| Forschung & Entwicklung | Katalyse, Polymeroberflächen, funktionale Materialien in Automotive, Halbleiter, Pharma. |
Welche Materialien können mit XPS untersucht werden?
- Metalle, Legierungen, Metalloxide
- Gläser, Keramiken, Halbleiter, Wafer
- Polymere/Kunststoffe, Verbundwerkstoffe, beschichtete Folien
- Fasern, Vliese, Papiere; Pulver/Partikel; Pigmente/Tinten
- Biomaterialien/Implantate; organische/organisch-anorganische Schichten
- Gleitmittel/Öle; Katalysatoren; Korrosionsprodukte; Nanomaterialien (z. B. Ruße)

XPS Analyse in der Praxis: Anwendungsbeispiele & Case Studies aus Industrie & Forschung
Anwendungen der Photoelektronenspektroskopie finden sich unter anderem in der Automobilindustrie, der Mikroelektronik und Halbleiterindustrie, der Kunststoffverarbeitung, der Sensorik, der Beschichtungstechnik, der Medizintechnik oder auch der pharmazeutischen Industrie. Durch die Small-Spot-XPS können auch Untersuchungen innerhalb kleiner Messbereiche (Ø ~ 30 µm), beispielsweise auf Bondpads oder Kontaktpunkten, durchgeführt werden.
Wir beraten Sie gerne zu Ihren Aufgabenstellungen - Nehmen Sie jetzt Kontakt zu uns auf.
Physikalische Grundlagen der XPS

Prinzip: Bestrahlung mit weicher Röntgenstrahlung (z. B. Al Kα, Mg Kα) → Emission von Photoelektronen aus Kernorbitalen. Bindungsenergie ergibt sich aus:
(mit Austrittsarbeit ΦS des Spektrometers; hinreichender elektrischer Kontakt vorausgesetzt).
- Informationstiefe ~1–10 nm (Normalemission, 99 % des Signals aus obersten nm).
- Elementidentifikation über charakteristische Bindungsenergien der Orbitale (1s, 2p, …).
- Quantifizierung über Peakflächen nach RSF-Korrektur.
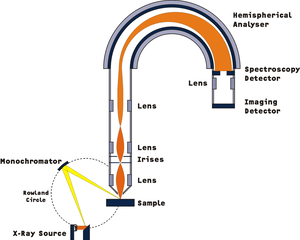
Nachweis der Photoelektronen (Hemisphärenanalysator)
Elektronenspektrometer mit halbkugelförmigen Elektroden (Hemispherical Analyzer) und elektronenoptischen Linsen. Messungen mit konstanter Pass-Energie für konstante Energieauflösung; weite Bereiche durch Retardierungsspannung im Linsensystem. Fehlerquellen: Aufladung, mangelhafte Referenzierung.
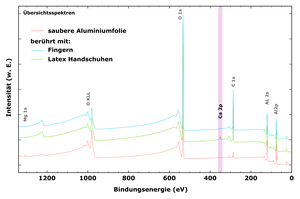
die mit Latexhandschuh bzw ohne Handschue berührt wurde.
Photoelektronenspektren (Survey & High Resolution)
Survey / Übersichts-Spektren zeigen alle detektierbaren Elemente und dienen als Ausgangspunkt der Analyse. High-Resolution-Spektren (z. B. C 1s, O 1s, Si 2p, Al 2p) liefern Bindungszustände; quantitative Auswertung erfolgt über Peakflächen (RSF-korrigiert). Unter RSF versteht man Relative Empfindlihkeitsfaktoren (ENglisch: Relative Sensitivity Factors). Diese geben grob gesagt an wie empfindlich verschiedene Elemente mit der XPS nachgewiesen werden können, die Angabe erfolgt typischerweise relativ zu einem Referenz-Element wie z.B. Kohlenstoff.
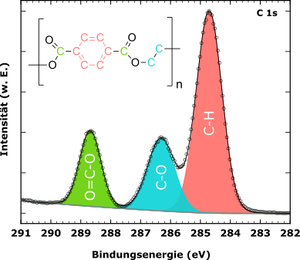
in der XPS. Aus der gemessenen kinetischen Energie des
Photoelektrons lässt sich unter Kenntnis der Photonen-
energie die Bindungsenergie im Festkörper bestimmen.
Analyse von Bindungszuständen (chemical shift)
Chemische Verschiebung der core-level Peaks korreliert mit Oxidationszahl und lokaler Umgebung.
Beispiel: C 1s in PET zeigt mehrere Komponenten (C–C, C–O, O–C=O). Je nach Elektronegativität der Bindungspartner werden die an der Bindung beteiligten Valenzelektronen mehr oder weniger stark vom Atomkern "abgezogen", was zu den messbaren Verschiebungen der Energieniveaus der kernnahen Elektronen (hier C 1s) führt.
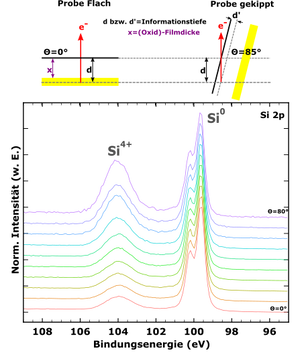
Tiefeninformationen: ARXPS & Schichtdickenbestimmung
ARXPS steht für Angle‑Resolved X‑ray Photoelectron Spectroscopy – auf Deutsch: Winkelaufgelöste Röntgen‑Photoelektronenspektroskopie.
Die Variation des Emissionswinkels (0–85°) reduziert die effektive Informationstiefe und erhöht so die Oberflächenempfindlichkeit. Die ermöglicht eine zerstörungsarme Tiefeninformation nahe der Oberfläche (bis etwa 10 nm).
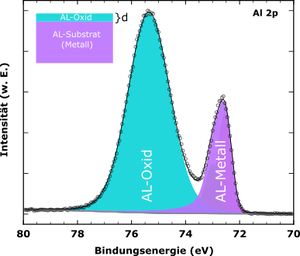
Schichtdickenbestimmung in Normalemission:
Aus dem Intensitätsverhältnis Metall/oxidischer Anteil (z. B. Al 2p ~73/75 eV) lässt sich die Oxidschichtdicke (Beispiel: ~4,9 nm) mit Hilfe eines Mathematischen Modells abschätzen; über O 1s kann das Oxid/Hydroxid-Verhältnis ergänzt werden.

Sputter-Tiefenprofilmessungen
Durch sequenzielles Ionenätzen (Ar+, Ar-Cluster) und nachgeschaltete XPS-Analysen entstehen Konzentrationsprofile über den Schichtaufbau; bei bekannter Ätzrate ist die Tiefe metrisch skalierbar (Kalibrierung z. B. über SiO2 oder Ta2O5).

Argon-Cluster-Ionen (GCIB) für empfindliche Materialien
GCIB ermöglicht Tiefenprofilierung organischer/empfindlicher Schichten (Polymere, OLEDs, Biocoatings) bei minimalen Strahlenschäden (effektive Energie ~1–20 eV pro Atom). Ideal für „Recovery“-Strategien nach monoatomarem Beschuss und für polymerbasierte Mehrschichtsysteme.

Typische GCIB-Anwendungen
- Tiefenprofile von Polymeren (mit Erhalt der Bindungsinformation)
- Mehrschichtige Polymerstrukturen, Mischmaterialien (polymer/anorganisch)
- Schnelle, schonende Oberflächenreinigung; Oxid-/Glasreinigung
- Graphen- und Polymerelektronik, biomedizinische Beschichtungen, organische/anorganische Solarzellen
- Vorbereitung von High-k-Materialien für ARXPS
Technische Daten (Instrument)
Technische Daten der XPS-Instrumente:
| Merkmal | Spezifikation |
|---|---|
| Röntgenquelle | Al Kα, monochromatisiert |
| Nachweisbare Elemente | Li–U; chemische Bindungszustände |
| Nachweisgrenze | 0,05–1 at% (elementabhängig), Sub-Monolagen |
| Informationstiefe | ca. 1–10 nm |
| Laterale Auflösung | ab. 10 µm |
| Chemische Auflösung | ~ 0,1 eV |
| Quantitative Analyse | Ja |
| Tiefenprofilanalysen | Ja (Tiefe bis 1–2 µm) |
| Winkelabhängige XPS (ARXPS) | Ja |
| Erweiterte Fähigkeiten | Sputter-Tiefenprofile (monoatomare Ar-Ionen, Ar-Cluster), Zalar-Rotation, 2D-Mapping, Linienprofile, Small-Spot, Ladungskompensation, CCD-Dokumentation |
| Probengröße | Max. 60 × 60 mm, Höhe 15 mm |
| Voraussetzungen | Vakuumkompatible Festkörper/viskose Öle; keine nassen oder stark magnetischen Proben |

FAQ - Photoelektronenspektroskopie (XPS)
XPS ist eine hochsensitive, zerstörungsfreie analytische Technik zur chemischen Untersuchung von Oberflächen und dünnen Schichten. Bei der Analyse wird die Probe mit Röntgenstrahlen bestrahlt, wodurch Photoelektronen aus den Atomen emittiert werden. Die Messung der kinetischen Energie dieser Elektronen ermöglicht präzise Rückschlüsse auf die elementare Zusammensetzung, Oxidationszustände und chemische Bindungen des Materials in den obersten 1 bis 10 Nanometern.
Eine XPS-Analyse liefert drei zentrale Informationen:
- Quantitative Elementzusammensetzung (alle Elemente außer H und He).
- Chemische Bindungszustände (z. B. Unterscheidung zwischen Metall und Oxid oder verschiedenen Polymergruppen).
- Schichtdickenbestimmung und Tiefenprofilierung (durch Sputtern oder winkelabhängige Messungen) von ultradünnen Schichten (bis ca. 2 µm).
XPS ist ein Schlüsselwerkzeug in der Materialwissenschaft und Fehleranalytik. Typische Anwendungen sind die Qualitätskontrolle von Beschichtungen, die Aufklärung von Haftungsproblemen (Delaminationen), die Untersuchung von Korrosionsmechanismen und die Kontaminationsanalyse von Oberflächen in der Halbleiter- und Medizintechnik.
Die Probe muss vakuumkompatibel sein, da die Messung im Ultrahochvakuum (UHV) stattfindet. Das bedeutet, die Proben müssen fest, trocken und dürfen nicht ausgasen. Übliche Proben sind Metalle, Polymere, Keramiken und Gläser. Maximale Abmessungen sind laborabhängig (z. B. bis zu 60 x 60 x 20 mm³).
|
Merkmal
|
Spezifikation
|
|
Röntgenquelle
|
Al Kα Strahlung, monochromatisiert
|
|
Nachweisbare Elemente
|
Li bis U; chemische Bindungszustände
|
|
Nachweisgrenze
|
0,05 - 1 At% (Elementabhängig), Sub-Monolagen
|
|
Informationstiefe
|
ca. 1 - 10 nm
|
|
Laterale Auflösung
|
ca. 30 µm
|
|
Chemische Auflösung
|
~ 0.2 eV
|
|
Quantitative Analysetechnik
|
✔
|
|
Tiefenprofilanalysen
|
✔ (Tiefe bis 1-2 µm)
|
|
Winkelabhängige XPS
|
✔
|
|
Erweiterte Fähigkeiten
|
Sputter-Tiefenprofile: monoatomare Argon-Ionenquelle, Argon Cluster-Ionenquelle, rotierbarer Probenteller (Zalar Rotation), AR-XPS (winkelabhängige XPS-Messungen), 2D-Mapping / Imaging, Linienprofilierung, Small-Spot XPS, Auswahl und Dokumentation (CCD-Kamera) spezifischer Messpositionen mit ~µm Präzision, Messung von Isolatoren mit präziser Ladungskompensation.
|
|
Probengröße
|
Max. 60x60 mm, Höhe 15 mm
|
|
Vorraussetzungen
|
alle Vakuum kompatiblen Festkörper und viskosen Öle.
keine stark magnetischen oder nassen Proben! |

Mittels der XPS (Photoelektronenspektroskopie) sind u.a. die Oberflächen der folgenden Materialien analysierbar:
- Metalle, Metall-Legierungen und Metalloxide
- Gläser
- Fasern, Vliese und Papiere
- Pulver und Partikel
- Keramische Werkstoffe / Keramiken
- Polymere, Kunststoffe
- Farben, Pigmente (Farbpigmente, Effektpigmente)
- Tinten
- Biomaterialien und Implantate
- Halbleitermaterialien
- Wafer
- Kompositematerialien, Verbundwerkstoffe
- Klebstoffe, Leime, Harze
- Korrosionsprodukte und Korrosionsinhibitoren
- Katalysatoren
- chemisch funktionalisierte/modifizierte Oberflächen
- organische Beschichtungen
- beschichtete Folien
- organische Verbindungen
- Nanomaterialien wie Ruße
- Gleitmittel, Öle
- ...
Method-Selector: Welche Frage – welche Methode?
Der Method‑Selector zeigt auf einen Blick, welche analytische Methode oder Methodenkombination – von XPS über ARXPS und Sputter‑Tiefenprofilen bis hin zu ToF‑SIMS, REM/EDX oder FTIR – für Ihre spezifische Fragestellung in der Materialprüfung, Fehleranalytik oder Qualitätssicherung die präzisesten Ergebnisse liefert. Im Zweifelsfall lassen Si sich gerne unverbindlich durch unsere Spezialisten beraten.
| Fragestellung (exemplarisch) | Primäre Methode(n) |
|---|---|
| Kontamination identifizieren (organisch/anorganisch) | XPS (C 1s / O 1s / Si 2p …) + FTIR; ToF‑SIMS für Spuren/Verteilungen |
| Kontamination identifizieren (Partikel) | REM/EDX + FTIR (Mikroskopie) |
| Oxidationszustände / Passivierung prüfen | XPS (High‑Resolution), ARXPS für sehr dünne Oxide |
| Schichtdicke / Profil | XPS (Berechnung mit Hilfe von Modellen, ARXPS), XPS Sputter‑Tiefenprofil; ToF‑SIMS für 3D/Spuren |
| Haftungs‑ / Benetzungsprobleme | XPS + Kontaktwinkel + ToF-SIMS |
| Metall‑ / Elektronik‑Fehlerbilder | XPS (Bond Pads), REM/EDX ergänzend für Morphologie/Elemente |
| Oberflächenstrukturen / Stufenhöhen / Morphologie / Rauheiten |
AFM (Rasterkraftmikroskopie) Optische Profilometrie |
Kontakt und weitere Schritte - Haben Sie noch Fragen ?
Kontaktieren Sie uns unverbindlich und sprechen Sie mit unseren Experten über Ihre Aufgabenstellung oder senden Sie uns direkt Ihre Probeninformationen.

